
電気AFMモードを解き明かす
Nanosurf AFMは、導電性AFM(c-AFM)、ケルビンプローブ力顕微鏡(KPFM)、圧電応答力顕微鏡(PFM)、走査型マイクロ波顕微鏡(SMM)などの電気特性測定を行うことが可能です。
原子間力顕微鏡(AFM)を用いた半導体表面の測定結果です。
Nanosurf社では大型のシリコンウエハであっても非破壊で表面の粗さパラメータ(ラフネス)の計測が可能です。
詳細は下記アプリケーションノートをご参照ください。
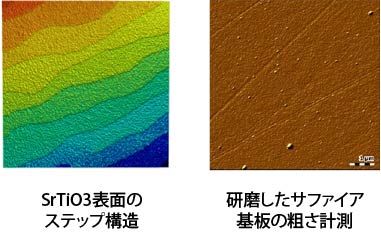

Nanosurf社製 原子間力顕微鏡 AFM
このアプリケーションの詳細情報をご覧になりたい方は、以下のリンクよりアプリケーションノートをダウンロードください。

Nanosurf Surface roughness measurement アプリケーションノート(英文)

Nanosurf AFMは、導電性AFM(c-AFM)、ケルビンプローブ力顕微鏡(KPFM)、圧電応答力顕微鏡(PFM)、走査型マイクロ波顕微鏡(SMM)などの電気特性測定を行うことが可能です。
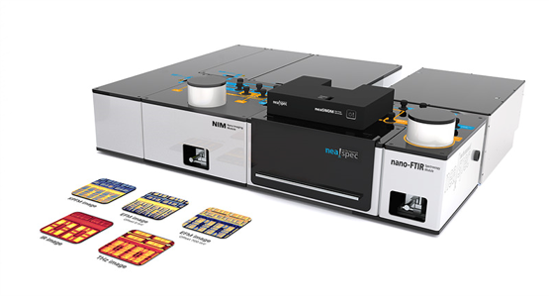
neaSCOPEは、「FT-IR」と「原子間力顕微鏡(AFM)」を融合した装置です。

neaSCOPEは、「FT-IR」と「原子間力顕微鏡(AFM)」を融合した装置です。

neaSCOPEは、「FT-IR」と「原子間力顕微鏡(AFM)」を融合した装置です。

原子間力顕微鏡(AFM)を用いた磁気力(MFM)の測定結果です。

原子間力顕微鏡(AFM)を用いたMoS2(二硫化モリブデン)の表面電位差の測定結果です。

原子間力顕微鏡(AFM)を用いたサンプル導電性の測定結果です。
電話・メールでも承っております
こちらの製品に関するお問い合わせ、資料請求、見積依頼は
お電話、メールでも承っております。お気軽にご相談ください。
03-5964-6620
info@qd-japan.com
営業時間:9:00〜17:00
(土日祝・年末年始・会社休業日を除く)